富士通研究所、先端LSIのソフトエラー発生率を短期間で高精度に測定する技術を開発
エンタープライズ
その他
-

10G光回線導入レポ
-

富士通研究所、次世代FeRAM用新メモリ材料を開発〜1,000億回の書き換えを実現
-

富士通研とハインリッヒ・ヘルツ研、光雑音を低減する技術を開発〜毎秒107Gbpsの光信号処理で実証
同技術は、中性子線の強度、およびエネルギー分布を正確に測定する中性子線測定器とソフトエラー測定システムを組み合わせて同時に測定することで、中性子線の強度やエネルギー分布とソフトエラー発生率の関係を正確に評価することを可能にしたほか、建物の内と外で中性子線測定を行なうことによって、建物の遮蔽効果がソフトエラー発生率におよぼす影響を評価したもの。また、ソフトエラーの発生率を高精度に評価するため、低地の10倍以上の中性子線の強度が推定されたすばる望遠鏡があるハワイのマウナケア山頂で測定を実施し、中性子線エネルギー分布測定に成功し、短期間で高精度なエラー発生数の統計データを取得することに成功した。
マウナケナ山頂での中性子線の強度は東京の約16倍、さらに遮蔽効果により東京の7.4倍という結果で、マウナケア山頂で測定したソフトエラー発生率に、7.4分の1倍を掛けて算出した値は、東京で測定した従来のデータや計算値にほぼ一致した。さらに、マウナケア山頂における測定では、90nm世代のSRAM1,024個のサンプルに対して約2,400時間の測定を行ったところ、36回ものソフトエラーを検出できた。
関連ニュース
-
 富士通研究所、次世代FeRAM用新メモリ材料を開発〜1,000億回の書き換えを実現
富士通研究所、次世代FeRAM用新メモリ材料を開発〜1,000億回の書き換えを実現
-
 富士通研とハインリッヒ・ヘルツ研、光雑音を低減する技術を開発〜毎秒107Gbpsの光信号処理で実証
富士通研とハインリッヒ・ヘルツ研、光雑音を低減する技術を開発〜毎秒107Gbpsの光信号処理で実証
-
 富士通、従来品の1/10以下のサイズの高速計算ノード相互接続用超小型光リンクモジュール技術を開発
富士通、従来品の1/10以下のサイズの高速計算ノード相互接続用超小型光リンクモジュール技術を開発
-
 富士通、世界最小となるモバイルWiMAX端末向けRFモジュールを新発売〜MIMO技術に対応
富士通、世界最小となるモバイルWiMAX端末向けRFモジュールを新発売〜MIMO技術に対応
-
 富士通研、標準CMOS技術で77GHz動作の高出力増幅器を開発——ITS車載レーダなどに応用可能
富士通研、標準CMOS技術で77GHz動作の高出力増幅器を開発——ITS車載レーダなどに応用可能
-
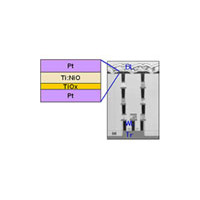 富士通研究所、次世代フラッシュメモリを担う低消費電力ReRAMを開発
富士通研究所、次世代フラッシュメモリを担う低消費電力ReRAMを開発
-
 富士通研究所、32nm世代以降のロジックLSI向けの高信頼性多層配線技術を開発
富士通研究所、32nm世代以降のロジックLSI向けの高信頼性多層配線技術を開発
-
 富士通、SmartCODEC内蔵の車載ネットワーク用LSI「MB88388A」「MB88389」出荷開始
富士通、SmartCODEC内蔵の車載ネットワーク用LSI「MB88388A」「MB88389」出荷開始
-
 富士通、下り900Mbpsの伝送能力を有するドコモ向け「Super 3G無線基地局装置」を実現
富士通、下り900Mbpsの伝送能力を有するドコモ向け「Super 3G無線基地局装置」を実現
-
 富士通、3次元をリアルタイム処理するロボット視覚用LSI
富士通、3次元をリアルタイム処理するロボット視覚用LSI
-
 「ラグビーワールドカップ2007」でH.264フルHD映像の日欧間生中継——富士通
「ラグビーワールドカップ2007」でH.264フルHD映像の日欧間生中継——富士通
-
 ネットの品質が“見える”ように? 富士通研究所が「見える化」計測技術を開発
ネットの品質が“見える”ように? 富士通研究所が「見える化」計測技術を開発